TLP接合
TLP接合(Transient Liquid Phase 接合)は、比較的低い温度で接合を行いながら、最終的には高い耐熱性を持つ接合層を得られる技術です。半導体デバイスやパワーモジュールなど、高い信頼性が求められる分野で利用されています。
接合する材料の間に 接合母材と低融点金属と を含む層を配置し、密着させてから加熱することで、接合界面に 液相 が発生します。
この液相になった低融点金属は接合面の細かな隙間へ広がり、均一に満たしていきます。その後、低融点金属は周囲の接合母材に対して拡散して次第に消失し、安定した固相の合金層が形成されます。
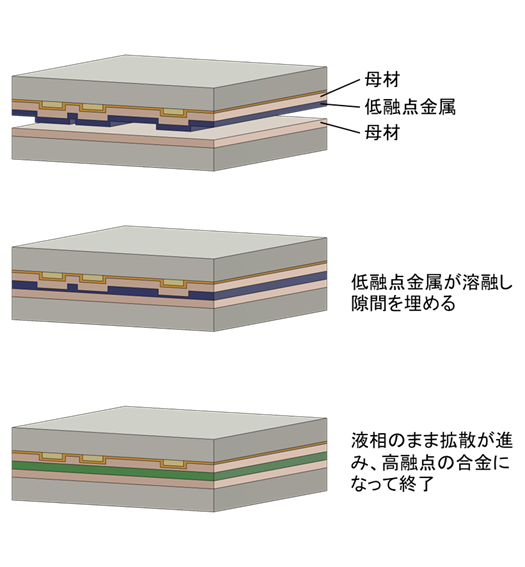
接合後は元の低融点金属よりも高い融点を持つ構造となるため、高温環境でも安定した使用が可能になります。
しかし、実際には加熱初期の段階で、低融点金属が液相になる前から母材との拡散が徐々に進行します。したがって、低融点金属層の膜厚が足りなかったり、ゆっくり昇温したりしていると、低融点金属が液相になる前にすべて合金化してしまい、接合に失敗します。
また、各層の膜厚の設計を誤ったり、適切な加熱条件で接合しなかった場合には、 ボイドやカーケンダルボイド (Kirkendall void)と呼ばれる微小な空隙が生じることがあります。これは、溶融金属の行き渡り不足や金属の拡散速度の影響などが原因です。
材料やプロセス条件を適切に設計することで、ボイドの発生を抑え、高品質で信頼性の高い接合を実現できますが、設備の調達も含めて難易度はやや高い接合技術だといえます。
低融点金属として錫(Sn)を、母材に銅(Cu)を用いたTLP接合の実績があります。詳細についてはお気軽にお問い合わせください。
(参考資料:K. Hikichi et al., “Sn-Cu thin film transient liquid phase bonding test with different underlayers using fully-in-vacuum wafer aligner/bonder” 2013 Transducers & Eurosensors XXVII, 2013)

